Характеристики и принцип работы IGBT ( БТИЗ- Биполярный транзистор с изолированным затвором )
05 августа 2024
КАТАЛОГ
I Введение
| |
Ⅱ Структура IGBT
| |
Ⅲ Рабочие характеристики
| 1.Статические характеристики
|
2.Динамические характеристики
| |
Ⅳ Принцип работы IGBT
| 1.Включите
|
2.Выключение
| |
3.Блокировка и защелкивание
| |
Ⅴ История IGBT
| |
I Введение
IGBT, биполярный транзистор с изолированным затвором, представляет собой составное полностью управляемое напряжением силовое полупроводниковое устройство, состоящее из BJT (биполярного транзистора) и IGFET (полевой транзистор с изолированным затвором). Он обладает преимуществами как высокого входного сопротивления MOSFET, так и низкого падения напряжения при включении GTR. Напряжение насыщения GTR уменьшено, а плотность тока большая, но ток возбуждения больше. Мощность привода MOSFET очень мала, а скорость переключения высока, но падение напряжения проводимости велико, а плотность тока мала. IGBT сочетает в себе преимущества двух вышеупомянутых устройств, мощность возбуждения невелика, а напряжение насыщения снижено. Он очень подходит для использования в преобразовательных системах с постоянным напряжением 600 В и выше, таких как двигатель переменного тока, инвертор, импульсный источник питания, схема освещения, тяговый привод и другие области.
Модуль IGBT - это модульный полупроводниковый продукт, который упакован с помощью IGBT (биполярного транзистора с изолированным затвором) и FWD (диода свободного хода) через специальный цепной мост. Упакованный модуль IGBT непосредственно применяется к такому оборудованию, как инверторы и источники бесперебойного питания ИБП. Модуль IGBT обладает характеристиками энергосбережения, удобной установки и обслуживания, а также стабильным тепловыделением. Как правило, IGBT также относится к модулю IGBT. С развитием таких концепций, как энергосбережение и защита окружающей среды, такие продукты будут становиться все более и более распространенными на рынке. IGBT является основным устройством для преобразования и передачи энергии, широко известным как "центральный процессор" силовых электронных устройств, и широко используется в железнодорожном транспорте, интеллектуальных сетях, аэрокосмической промышленности, электромобилях и новом энергетическом оборудовании.
Ⅱ Структура IGBT
На рисунке показана N-канальная усиленная структура биполярного транзистора с изолированным затвором. Область N+ называется областью источника, а электрод на ней называется источником (т.е. эмиттером E). Основание N называется областью стока. Управляющей областью устройства является область затвора, а электрод на нем называется затвором (т.е. затвором G). Канал формируется на границе области затвора. Область P-типа между полюсами C и E называется областью подканала. Область P+ на другой стороне области слива называется дренажным инжектором. Это уникальная функциональная область IGBT и образует PNP-биполярный транзистор вместе с областью стока и областью подканала. Он действует как излучатель, вводит отверстия в сток, проводит модуляцию проводимости и снижает напряжение во включенном состоянии устройства. Электрод в зоне впрыска дренажа называется дренажом (т.е. коллектором C).
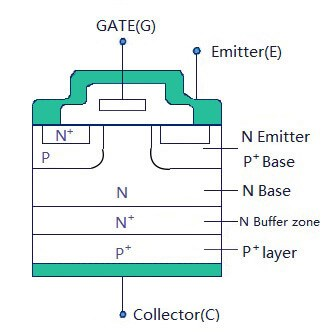
N-канальная улучшенная структура биполярного транзистора с изолированным затвором
Функция переключения IGBT заключается в формировании канала путем добавления положительного напряжения на затворе для подачи базового тока на PNP (ранее NPN) транзистор для включения IGBT. Напротив, добавление напряжения обратного затвора для устранения канала и отключения базового тока приведет к отключению IGBT. Метод возбуждения IGBT в основном такой же, как и у MOSFET. Ему нужно только управлять входным N-канальным МОП-транзистором, поэтому он обладает высокими характеристиками входного импеданса. После того, как канал МОП-транзистора сформирован, отверстия (второстепенные носители) вводятся из основания P + в N-слой для модуляции проводимости N-слоя и уменьшения сопротивления N-слоя. Таким образом, IGBT имеет низкое напряжение во включенном состоянии даже при высоком напряжении.
IGBT - это трехполюсное устройство. Он имеет затвор G, коллектор c и эмиттер E. Структура и упрощенная эквивалентная схема IGBT показаны на рисунке.
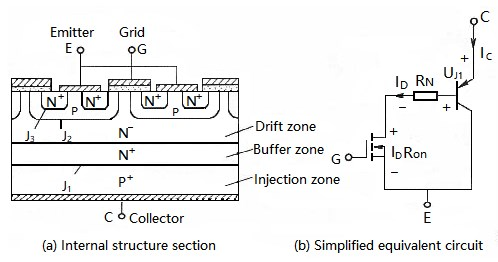
Внутренняя структура IGBT и эквивалентная схема
На рисунке показана принципиальная схема поперечного сечения внутренней структуры N-IGBT в сочетании с N-канальным VDMOSFFT и GTR. IGBT имеет на один слой больше области имплантации P+, чем VDMOSFET, образуя PN-переход большой площади J1. Область инжекции P + излучает неосновные носители в область N-основания, когда IGBT включен, поэтому проводимость области дрейфа модулируется, тогда IGBT обладает высокой способностью пропускать ток. Слой N+ между областью инжекции P+ и областью N-дрейфа называется буферной зоной. Существует ли буфер, который определяет различные характеристики IGBT. IGBT с N * буфером называется асимметричным IGBT, также называемым сквозным IGBT. Он обладает преимуществами небольшого прямого падения напряжения, короткого времени выключения и небольшого остаточного тока во время выключения, но его способность к обратному блокированию относительно слаба.IGBT без N-буфера называется симметричным IGBT, также называемым непробиваемым IGBT. Он обладает сильной способностью прямой и обратной блокировки, но его другие характеристики не так хороши, как у асимметричных IGBT.
Упрощенная эквивалентная схема, показанная на рисунке, показывает, что IGBT представляет собой структуру Дарлингтона, состоящую из GTR и MOSFET. Часть этой структуры управляется МОП-транзистором, а другая часть представляет собой PNP-транзистор с толстой базой.
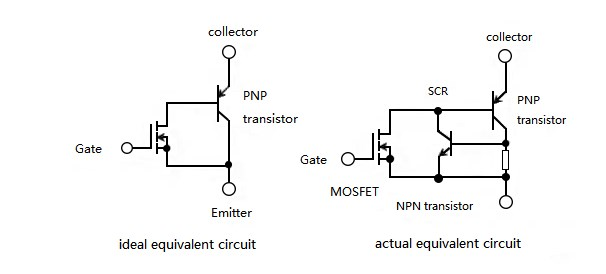
Идеальная эквивалентная схема и фактическая эквивалентная схема IGBT
Из эквивалентной схемы IGBT можно использовать в качестве монолитного двухмоп-транзистора, образованного соединением Дарлингтона биполярного транзистора PNP и силового МОП-транзистора.
Следовательно, когда между затвором и эмиттером подается положительное напряжение для включения силового МОП-транзистора, база-коллектор PNP-транзистора подключается к низкому сопротивлению, так что PNP-транзистор находится в проводящем состоянии. Добавляя слой p +, вводите отверстия из слоя p + в основание n во включенном состоянии, тем самым вызывая изменение проводимости. Таким образом, он может получить чрезвычайно низкое сопротивление по сравнению с силовым МОП-транзистором.
После этого, когда напряжение между затвором и эмиттером равно 0 В, силовой МОП-транзистор находится в выключенном состоянии, а базовый ток PNP-транзистора отключается, таким образом, находясь в выключенном состоянии.
Как упоминалось выше, IGBT, как и силовой MOSFET, может управлять включением и выключением с помощью сигнала напряжения.
Ⅲ Рабочие характеристики
1. Статические характеристики
Статические характеристики IGBT в основном включают вольт-амперные характеристики и характеристики передачи.
Вольт-амперная характеристика IGBT относится к кривой зависимости между током стока и напряжением затвора, когда в качестве параметра используется Ugs напряжения затвора-источника. Отношение выходного тока стока регулируется Ugs напряжения затвора-источника. Чем выше Ugs, тем больше идентификатор. Он аналогичен выходным характеристикам GTR и также может быть разделен на зону насыщения 1, зону усиления 2 и характеристики пробоя. В выключенном состоянии IGBT прямое напряжение подается на переход J2, а обратное напряжение подается на переход J1. Если нет буфера N+, напряжение прямой и обратной блокировки может быть на одном и том же уровне. После добавления буфера N+ напряжение обратного отключения может достигать уровня только в десятки вольт, что ограничивает область применения IGBT.
Передаточная характеристика IGBT относится к кривой зависимости между током выходного стока Id и напряжением Ugs затвора-источника. Он имеет те же характеристики передачи, что и МОП-транзистор. Когда напряжение затвора-источника меньше напряжения включения Ugs(th), IGBT находится в выключенном состоянии. В большей части диапазона тока стока после включения IGBT Id имеет линейную зависимость от Ugs. Максимальное напряжение затвора-источника ограничено максимальным током стока, и его оптимальное значение обычно составляет около 15 В.
2.Динамические характеристики
Динамические характеристики также называются характеристиками переключения. Характеристики переключения IGBT делятся на две части: одна - скорость переключения, основным показателем является время каждой части процесса переключения; другая - потери в процессе переключения.
Коммутационная характеристика IGBT относится к соотношению между током стока и напряжением сток-источник. Когда IGBT находится во включенном состоянии, его значение B чрезвычайно низкое, потому что его PNP-транзистор является транзистором с широкой базой. Хотя эквивалентная схема представляет собой структуру Дарлингтона, ток, протекающий через МОП-транзистор, становится основной частью общего тока IGBT. В это время напряжение состояния включения Uds(on) может быть выражено следующей формулой:
Uds(вкл.) = Uj1 + Udr + IdRoh
Где Uj1 - прямое напряжение перехода JI, его значение составляет 0,7 ~ 1 В; Udr - падение напряжения на удлинительном сопротивлении Rdr; Roh - сопротивление канала.
Текущие идентификаторы состояния включения могут быть выражены следующей формулой:
Идентификаторы=(1+Bpn)Imos
В формуле Imos - это ток, протекающий через МОП-транзистор.
Из-за эффекта модуляции проводимости в области N+ падение напряжения IGBT во включенном состоянии невелико. Падение напряжения во включенном состоянии IGBT с выдерживаемым напряжением 1000 В составляет от 2 до 3 В. Когда IGBT находится в выключенном состоянии, существует лишь небольшой ток утечки.
IGBT работает как MOSFET большую часть времени во время процесса включения. На поздней стадии процесса падения Uds напряжения стока-источника PNP-транзистор переходит из области усиления в область насыщения, и добавляется время задержки. td (on) - время задержки включения, а tri - время нарастания тока. В практических приложениях время включения тока стока ton равно сумме td (on) tri, а время падения напряжения сток-источник складывается из tfe1 и tfe2.
Для запуска и выключения IGBT требуется, чтобы между его затвором и базой добавлялось положительное напряжение и отрицательное напряжение, и напряжение затвора может генерироваться различными управляющими цепями. При выборе этих схем привода он должен основываться на следующих параметрах: требования к смещению при отключении устройства, требования к зарядке затвора, требования к долговечности и условия подачи питания. Поскольку импеданс затвора-эмиттера IGBT велик, для запуска можно использовать технологию возбуждения MOSFET. Однако, поскольку входная емкость IGBT больше, чем у MOSFET, смещение отключения IGBT должно быть выше, чем у многих схем привода MOSFET.
Во время выключения IGBT форма сигнала тока стока становится двумя сегментами. Поскольку после выключения МОП-транзистора накопленный заряд PNP-транзистора трудно быстро устранить, что приводит к длительному времени задержки тока стока. td (выкл.) - время задержки выключения, а trv - время нарастания напряжения Uds(f). Время падения Tf тока стока, часто задаваемое в практических приложениях, состоит из t(f1) и t(f2) на рисунке, а время отключения тока стока t(выкл.) =td(выкл.)+trv + t(f). В формуле: сумма td(выкл.) и trv также называется временем хранения.
Скорость переключения IGBT ниже, чем у MOSFET, но она значительно выше, чем у GTR. IGBT не нуждается в отрицательном напряжении затвора для уменьшения времени выключения при его выключении, но время выключения увеличивается с увеличением параллельного сопротивления затвора и эмиттера. Напряжение включения IGBT составляет от 3 до 4 В, что эквивалентно напряжению MOSFET. Падение напряжения насыщения при включении IGBT ниже, чем у MOSFET, и близко к GTR, а падение напряжения насыщения уменьшается с увеличением напряжения на затворе.
Мощность по напряжению и току официально коммерческих IGBT-устройств все еще очень ограничена, что далеко от удовлетворения потребностей развития технологии применения силовой электроники. Во многих приложениях в области высокого напряжения требуется, чтобы уровень напряжения устройства превышал 10 кВ. В настоящее время применение высокого напряжения может быть достигнуто только с помощью таких технологий, как последовательное высоковольтное соединение IGBT. Некоторые производители, такие как швейцарская ABB, разработали IGBT-устройства напряжением 8 кВ, использующие принцип мягкого пробивания. Высоковольтные и мощные IGBT-устройства 6500 В/600 А, произведенные EUPEC в Германии, были внедрены в практическое применение, и японская Toshiba также занялась этой областью.В то же время крупные производители полупроводников продолжают разрабатывать высоковольтные, высокоточные, быстродействующие, с низким падением напряжения насыщения, высокой надежностью и недорогими технологиями для IGBT, в основном с использованием производственных процессов ниже 1 мкм, и был достигнут некоторый новый прогресс в исследованиях и разработках.
Ⅳ Принцип работы IGBT
1. Включите
Структура кремниевого чипа IGBT очень похожа на структуру силового МОП-транзистора. Основное отличие заключается в том, что IGBT добавляет P+ подложку и N+ буферный слой. Один из МОП-транзисторов приводит в действие два биполярных устройства. Нанесение подложки создает соединение J1 между областями P+ и N+ корпуса трубки. Когда положительное смещение затвора приводит к тому, что область основания P меняется на противоположную под затвором, образуется N-канал. В то же время появляется ток электронов, и ток генерируется точно так же, как и силовой МОП-транзистор.
Если напряжение, генерируемое этим потоком электронов, находится в диапазоне 0,7 В, J1 будет смещен вперед. Некоторые отверстия вводятся в N-зону и регулируют удельное сопротивление между катодом и анодом. Таким образом, общая потеря электропроводности уменьшается, и запускается второй поток заряда. Конечным результатом является то, что в иерархии полупроводников временно появляются две разные топологии тока: поток электронов (ток MOSFET); ток дырок (биполярный).
2. Выключение
Когда к затвору прикладывается отрицательное смещение или напряжение на затворе ниже порогового значения, канал запрещен, и в N-область не вводятся отверстия. В любом случае, если ток МОП-транзистора быстро падает во время фазы переключения, ток коллектора постепенно уменьшается. Это связано с тем, что после начала коммутации в N-слое все еще остается несколько несущих (второстепенных несущих).Уменьшение этого значения остаточного тока (тока бодрствования) полностью зависит от плотности заряда при его выключении. Плотность зависит от нескольких факторов, таких как количество и топология легирующих добавок, толщина слоя и температура. Ослабление неосновной несущей приводит к тому, что ток коллектора имеет характерную форму сигнала следа. Ток коллектора вызывает следующие проблемы: 1. Повышенное энергопотребление; 2. Проблемы с перекрестной проводимостью, особенно в устройствах, использующих диоды свободного хода.
Поскольку след связан с рекомбинацией неосновных носителей, текущее значение следа должно быть тесно связано с температурой чипа и подвижностью отверстий, которая тесно связана с IC и VCE. Следовательно, в зависимости от достигнутой температуры возможно уменьшить это нежелательное влияние тока, действующего на конструкцию оконечного оборудования.
3. Блокировка и защелкивание
Когда на коллектор подается обратное напряжение, J1 будет управляться обратным смещением, и слой истощения расширится до N-области. Если толщина этого слоя будет уменьшена слишком сильно, эффективная блокирующая способность не будет получена. Поэтому этот механизм очень важен. С другой стороны, если вы слишком сильно увеличите размер этой области, это будет постоянно увеличивать перепад давления. Второй пункт ясно объясняет, почему падение напряжения устройств NPT выше, чем у эквивалентных (IC и скорость одинаковы) устройств PT.
Когда затвор и эмиттер закорочены и на клемму коллектора подается положительное напряжение, переход P/N J3 управляется обратным напряжением. В это время обедненный слой в области N-дрейфа все еще выдерживает внешнее приложенное напряжение.
При нормальных обстоятельствах основные различия между статическими и динамическими защелками заключаются в следующем:
Когда все тиристоры включены, происходит статическая фиксация. Динамическая фиксация происходит только при выключении тиристоров. Это особое явление серьезно ограничивает безопасную рабочую зону. Чтобы предотвратить вредные явления паразитных NPN и PNP транзисторов, необходимо принять следующие меры: предотвратить включение части NPN, изменить компоновку и уровень легирования соответственно и уменьшить общий коэффициент усиления по току NPN и PNP транзисторов. Кроме того, ток фиксации оказывает определенное влияние на коэффициент усиления по току устройств PNP и NPN.Следовательно, он имеет очень тесную взаимосвязь с температурой перехода; когда температура перехода и коэффициент усиления увеличиваются, удельное сопротивление области основания P будет увеличиваться и ухудшать общие характеристики. Поэтому производители устройств должны обращать внимание на поддержание определенного соотношения между максимальным значением тока коллектора и током фиксации, которое обычно составляет 1:5.
Ⅴ История IGBT
В 1979 году устройства коммутации питания с МОП-затвором были представлены миру как пионеры концепции IGBT. Это устройство выглядит как тиристороподобная структура (четырехслойная композиция P-N-P-N), которая характеризуется образованием V-образного канавчатого затвора в процессе сильного щелочного мокрого травления.
В начале 1980-х годов в IGBT был внедрен процесс DMOS (Двойной диффузионный металл-оксид-полупроводник), используемый в технологии изготовления силовых МОП-транзисторов. В то время структура кремниевого чипа представляла собой более толстую конструкцию типа NPT (non-punch through). Позже, благодаря использованию метода PT (сквозной перфорации) структуры, было получено значительное улучшение компромисса параметров. Это связано с технологическим прогрессом эпитаксии на кремниевых пластинах и использованием буферных слоев n+, рассчитанных на заданное блокирующее напряжение. За последние несколько лет правила проектирования этой структуры с плоскими затворами DMOS, изготовленной на эпитаксиальной пластине, разработанной PT, расширились с 5 микрон до 3 микрон.
В середине 1990-х годов структура trench gate вернулась к новой концепции IGBT, которая представляла собой новый процесс травления, реализованный с помощью технологии сухого травления кремния, заимствованной из процесса крупномасштабной интеграции (LSI), но это все еще была структура чипа типа punch-through (PT). В этой траншейной структуре достигается более важное улучшение компромисса между напряжением во включенном состоянии и временем отключения.
Технология Punch-through (PT) имеет относительно высокий коэффициент впрыска носителя, и поскольку она требует контроля срока службы неосновного носителя, ее эффективность транспортировки ухудшается. С другой стороны, технология без пробивки (NPT) основана на том факте, что она не сокращает срок службы неосновного носителя и обладает хорошей эффективностью транспортировки, но ее коэффициент впрыска носителя относительно низок. Кроме того, технология без пробивки (NPT) была заменена технологией мягкого пробивания (LPT), которая похожа на то, что некоторые люди называют технологией типа "мягкого пробивания" (SPT) или "отключения электрического поля" (FS), что делает общую эффект "затраты-производительность" был еще более улучшен.
В 1996 году CSTBT (биполярный транзистор с траншейным затвором с сохранением на носителе) позволил реализовать IGBT-модуль пятого поколения, в котором использовалась структура микросхемы со слабым пропусканием (LPT) и более продвинутый дизайн с широким расстоянием между ячейками. В настоящее время новые концепции, включающие функцию "обратного типа блокировки" или функцию "обратного типа проводимости" IGBT-устройств, изучаются для дальнейшей оптимизации.
Теперь сильноточные и высоковольтные IGBT были модулированы, и была изготовлена встроенная специальная схема привода IGBT. Его производительность выше, надежность всей машины выше, а объем меньше.